
計測条件:
■サンプル:半導体
■対物レンズ:100×(NA:0.95)、ズーム:2×、計測視野:70×70μm
■XY分解能:500×500pixel、Z計測分解能:0.3μm、Z測定幅:32μm
層構造内部の凹凸計測:
たとえば半導体パターンの上面に透明な膜がある場合、その膜下のパターンの計測が必要になることがあります。右にその一例を示します。図のように膜の外形を表示することや、あるいは測定条件を調節すると、透明な膜下にある四角の凹凸パターンが表示されます。光学顕微鏡下で透かしてみていたパターンを、レーザプローブで膜下の凹凸計測することで、その寸法形状を断面プロフィールなどから正確に把握します。
|
|
 |
| 図1 層構造における外層膜の外形 |
| |
| |
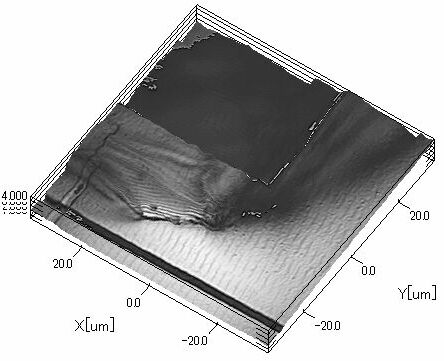 |
| 図2 膜内のパターン |
| |
| |
 |
 |
| 図3 膜の外形 |
図4 膜内のパターン |
|





